新聞資訊
半導體的生產流程主要分為制造、封裝、測試等幾個步驟。而集成電路封測行業包括封裝和測試兩個環節,封裝為主,測試為輔。封裝是保護芯片免受物理、化學等環境因素造成的損傷,增強芯片的散熱性能,實現電氣連接,確保電路正常工作。測試則是對芯片、電路等半導體產品的功能和性能進行驗證的步驟,以篩選出有結構缺陷或者功能、性能不符合要求的半導體產品,確保交付產品的正常應用。其中,封裝環節價值占比約為80%~85%,測試環節價值占比約15%~20%。

封測在半導體行業中的主要作用為保護、支撐、連接、散熱和可靠性。

半導體芯片的生產車間都有著嚴格的生產條件要求,比如恒溫恒濕,無塵潔凈等,芯片只有在適合的環境能才能正常發揮作用,而我們周圍的正常環境大多數情況下并不能做到這一點,所以需要封測來保護芯片,為其制造一個良好的工作環境。
支撐功能則有兩個部分,一為支撐芯片,固定好芯片便于電路連接,另一則是形成一定外型支撐整個器件,使得器件免收損壞。連接就如前文所說,封測環節會將芯片的I/O端口引出,這樣便于芯片后面與其他電路及器件的連接。
散熱則是通過封裝材料的特殊性及其他技術手段在封裝過程中為工作中的半導體芯片安排一定降溫裝置,以幫助其散熱。
可靠性功能是半導體最終流入市場的質量保證,如果半導體在設計上沒有缺陷,但因為封裝過程中的焊接質量存在缺陷就影響了產品使用,這會給半導體生產廠商帶來巨大的損失。半導體封裝環節是增加了芯片的可靠性,使得芯片性能更優秀,但封裝過程中也需要X射線檢測來保證其焊接質量。其次,測試的過程也對芯片進行了一輪質量的篩選,X射線能夠穿透封裝過的半導體器件,檢測出其內部生產工藝可能存在的質量缺陷,為流入市場的芯片增加了一重可靠性保障。
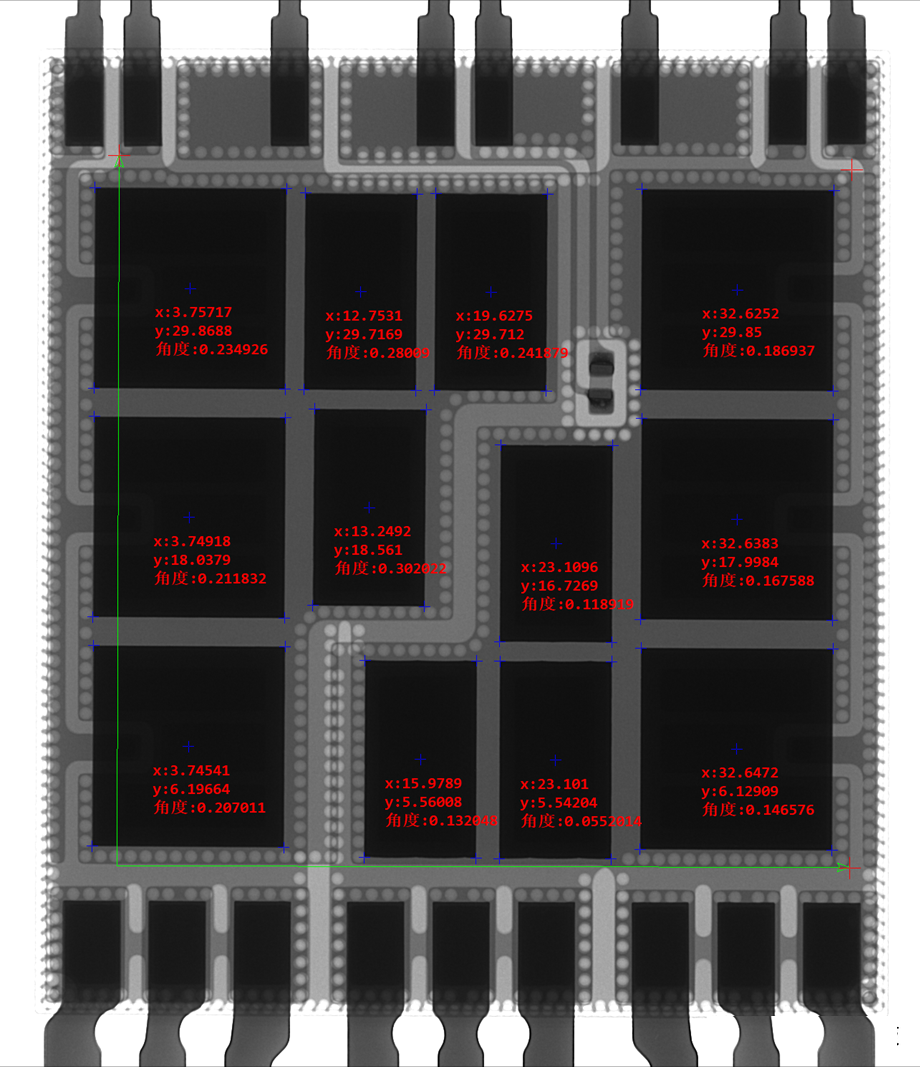
X射線半導體檢測裝備現已廣泛應用于集成電路,分立器件,傳感器和光電子器件。半導體封測在國內發展迅速,封裝后使用X射線對其進行測試是對封裝好的芯片進行生產工藝的檢測,以保證器件封裝后的質量,最終保證其性能。
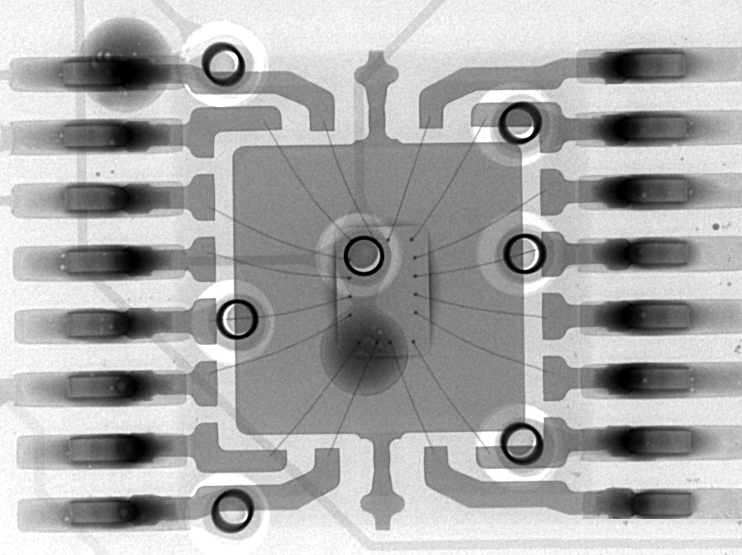
發布日期: 2024-07-18
發布日期: 2024-10-29
發布日期: 2025-02-19
發布日期: 2025-02-19
發布日期: 2024-05-07
發布日期: 2024-04-24
發布日期: 2023-11-27
發布日期: 2024-06-27
發布日期: 2025-05-19
發布日期: 2025-05-19
發布日期: 2025-05-19
發布日期: 2025-05-19
發布日期: 2025-05-19
